Harmadik generációs SiC MOSFET-ek használata nagy teljesítményű készülékekben a nagyobb teljesítmény és jobb hatásfok elérése érdekében
Contributed By DigiKey's North American Editors
2022-11-02
Az olyan nagy teljesítményt igénylő felhasználási területeken, mint az ipari motorok vezérlőegységei, a váltakozóáram- és egyenáram-átalakítók és inverterek, akkumulátortöltők és energiatároló rendszerek, könyörtelen a kényszer a jobb hatásfok, kisebb méretek és nagyobb teljesítmény elérésére. Ezek a teljesítményre vonatkozó agresszív követelmények meghaladták a szilícium (Si) MOSFET-ek képességeit, és új, szilícium-karbid (SiC) alapú tranzisztorarchitektúrák megjelenéséhez vezettek.
Bár ezek az újabb eszközök jelentős előnyöket kínáltak a legfontosabb teljesítménymutatókban, a tervezők bölcsen tették, ha óvatosak voltak az első generációs SiC eszközökkel szemben a különböző korlátozások és felhasználási bizonytalanságok miatt. A második generációs eszközök már jobb műszaki adatokat mutattak, és jobban tekintettel voltak az eszközök finomságaira. Ahogy nőtt a SiC MOSFET-ek teljesítménye, és fokozódott a piacra kerülési idő jelentette nyomás, a tervezők ezeket az újabb eszközöket kezdték használni a termékekkel kapcsolatos célkitűzések elérésére. A közelmúltban megjelent harmadik generációs eszközök már a nagy teljesítményű SiC-alapú eszközök kiforrottságát mutatják. Ezek az eszközök a legfontosabb paraméterek tekintetében javulást mutatnak, miközben építenek a korábbi generációkkal kapcsolatos gyakorlati tapasztalatokra és az azon generációkkal kapcsolatban szerzett szakértelemre.
Ez a cikk összehasonlítja a szilícium- (Si) és a szilícium-karbid (SiC) alapú eszközöket, majd ismerteti a harmadik generációs SiC MOSFET-ek fejlődését és az azokra való áttérést. Ezután a Toshiba Semiconductor and Storage Corp. (Toshiba) valós példáival mutatja be, hogyan segíthetnek ezek az eszközök a tervezőknek jelentős előrelépést elérni a nagy teljesítményű rendszerek tervezésében.
A szilícium és a szilícium-karbid összevetése
Az elmúlt évtizedek során a szilíciumalapú MOSFET-ek az alapszintű tápegységektől és inverterektől kezdve a motorvezérlő egységekig átalakították a nagy teljesítményű rendszerek tervezését. A szigetelt kapus bipoláris tranzisztorral (IGBT) együtt – amely funkcióit tekintve hasonló félvezető, de nagyon eltérő felépítéssel és tulajdonságokkal rendelkezik – a kapcsoló üzemmódra optimalizált Si MOSFET lehetővé tette az átmenetet a hagyományos, rossz hatásfokú, lineáris topológiákon alapuló áramátalakításról és -kezelésről a sokkal jobb hatásfokú és kisebb méretű, kapcsolt vezérlést alkalmazó megoldásokra.
A legtöbb ilyen konstrukció valamiféle impulzusszélesség-modulációt (PWM) használ a kívánt feszültség, áram vagy teljesítmény értékének zárt hurkú visszacsatolásos kapcsolásban történő előállítására és fenntartására. A szilícium MOSFET-ek használatának elterjedésével a velük szemben támasztott követelmények is nőttek. Ezen túlmenően a hatásfokra vonatkozó új célkitűzések (amelyek közül sok szabályozási előírásokon alapul), a villanyjárművek és az intelligensebb motorvezérlés, a megújuló energiaforrásokhoz szükséges energiaátalakítás és az ahhoz kapcsolódó energiatároló rendszerek piacai arra késztették a fejlesztőket, hogy ezek a MOSFET-ek jobbak legyenek, és többre legyenek képesek.
Ennek eredményeképpen jelentős mennyiségű kutatási és fejlesztési (K+F) munkát befektetve megnövelték a szilíciumalapú MOSFET-ek teljesítményét, de a kutatók felismerték, hogy ez az erőfeszítés elérte azt a határt, ahonnan már csökken a befektetett munka megtérülésének mértéke. Szerencsére elméletben volt egy alternatívájuk, amely olyan nagy teljesítményű kapcsolóeszközökre épült, amelyek hordozóanyagként (szubsztrátként) SiC-t használtak, nem pedig tisztán szilíciumot.
Miért érdemes SiC-t használni?
Különböző mélyfizikai okok miatt a SiC három fő villamos jellemzője jelentősen eltér a szilíciumétól, és mindegyik működésbeli előnyökkel jár, de vannak más, apróbb különbségek is (1. ábra).
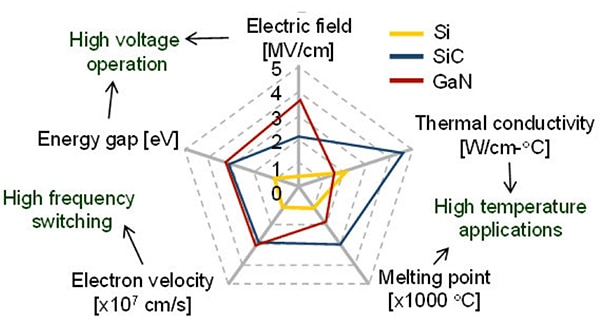 1. ábra: A SiC és a Si, valamint a gallium-nitrid (GaN) félvezető anyagok legfontosabb anyagjellemzőinek közelítő összehasonlítása (kép: Researchgate)
1. ábra: A SiC és a Si, valamint a gallium-nitrid (GaN) félvezető anyagok legfontosabb anyagjellemzőinek közelítő összehasonlítása (kép: Researchgate)
A három fő jellemző a következő:
- Magasabb kritikus átütési villamoserőtér-feszültség (kb. 2,8 MV/cm a 0,3 MV/cm-hez képest), így sokkal vékonyabb réteggel is lehetséges egy adott névleges feszültségen való működés, ami jelentősen csökkenti a nyelő (drain) és a forrás (source) közti nyitóirányú ellenállást (RDS(on)).
- Nagyobb hővezető képesség, ami adott keresztmetszeten nagyobb áramsűrűséget tesz lehetővé.
- Nagyobb tiltott sáv (a félvezetőkben és szigetelőkben a vegyértéksáv teteje és a vezetési sáv alja közötti energiakülönbség elektronvoltban kifejezve), ami nagy hőmérsékleten kisebb kúszóáramot eredményez. Emiatt a SiC diódákat és térvezérelt tranzisztorokat (FET, field effect transistor) gyakran nevezik nagy tiltott sávú (WBG, wide bandgap) eszközöknek.
Ennek eredményeképpen a SiC-alapú eszközök ugyanakkora szeletméret esetén akár tízszer nagyobb feszültséget képesek blokkolni, mint a csak szilíciumból készült eszközök, körülbelül tízszer gyorsabban kapcsolnak, és 25 °C-on feleakkora vagy kisebb az RDS(on) nyelő–forrás nyitóirányú ellenállásuk (természetesen mindezek csak hozzávetőleges adatok). Emellett a SiC eszközök lezárással kapcsolatos kapcsolási veszteségei is kisebbek, mivel nincs káros maradékáram. Ugyanakkor az a képességük, hogy sokkal magasabb hőmérsékleten, nagyjából 200 °C-on (a 125 °C-kal szemben) képesek működni, megkönnyíti a hűtés megtervezését, és csökkenti a hűtési problémákat.
Teljesítményjellemzőiknek és javulásuknak köszönhetően a SiC eszközök ma már előkelő helyet foglalnak el a teljesítmény–sebesség grafikont tekintve a felhasználási mátrixban, csatlakozva az IGBT-khez, a szilícium MOSFET-ekhez és a GaN eszközökhöz (2. ábra).
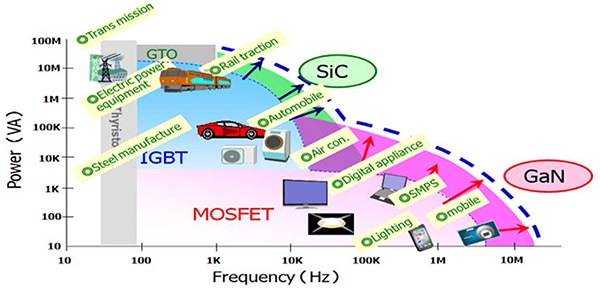 2. ábra: A SiC MOSFET-ek teljesítményjellemzői alkalmassá teszik ezeket az eszközöket számos felhasználási területen való használatra, a teljesítmény- és frekvenciaértékek széles skáláját felölelve (kép: Toshiba)
2. ábra: A SiC MOSFET-ek teljesítményjellemzői alkalmassá teszik ezeket az eszközöket számos felhasználási területen való használatra, a teljesítmény- és frekvenciaértékek széles skáláját felölelve (kép: Toshiba)
A SiC használatának alapját képező anyagtudománytól és eszközfizikától nem volt gyors és egyszerű az út a kereskedelmi forgalomban kapható SiC MOSFET-ek megjelenéséig (3. ábra). Az első SiC-alapú eszközöket – Schottky-diódákat – kiterjedt kutatási és gyártási tevékenységet követően 2001-ben mutatták be. Az ezt követő két évtizedben az ipar kifejlesztette és sorozatban gyártotta az első, második és harmadik generációs SiC MOSFET-eket. Mindegyik generáció célzott javulást kínál bizonyos paraméterek tekintetében, némileg eltérő kompromisszumokkal.
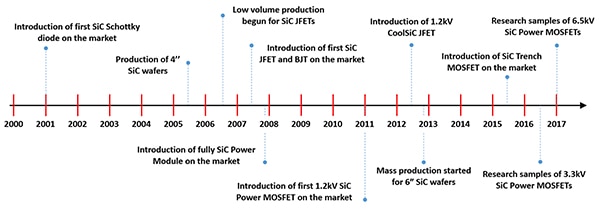 3. ábra: A kereskedelmi forgalomban kapható SiC-alapú eszközök története az első kereskedelmi forgalomba került SiC Schottky-diódákkal kezdődik, amelyek 2001-ben jelentek meg (kép: IEEE Transactions on Industrial Electronics – Az IEEE beszámolója ipari elektronikáról –, 2017)
3. ábra: A kereskedelmi forgalomban kapható SiC-alapú eszközök története az első kereskedelmi forgalomba került SiC Schottky-diódákkal kezdődik, amelyek 2001-ben jelentek meg (kép: IEEE Transactions on Industrial Electronics – Az IEEE beszámolója ipari elektronikáról –, 2017)
Fontos tisztázni a terminológiát: a SiC-alapú FET-ek a csak szilíciumból készült elődeikhez hasonlóan MOSFET-ek. A tágabb értelemben vett belső fizikai felépítésük hasonló, és mindkettő háromlábú eszköz, forrás, nyelő és kapu (source, drain és gate) érintkezővel. A különbség az, amit a nevük is mutat: a SiC-alapú FET-ek alapanyagként nem tisztán szilíciumot (Si), hanem szilícium-karbidot (SiC) használnak.
Kezdjük az első és második generációval
Egy kapcsolóeszköz teljesítményét számos paraméter jellemzi. A számos statikus paraméter között szerepel a legnagyobb üzemi feszültség és a legnagyobb névleges áram, valamint két statikus jóságmutató szám (FoM, figure of merit): az RDS(on) nyelő–forrás nyitóirányú ellenállás és a legnagyobb üzemi hőmérséklet, amelyek az adott félvezetőszelet méretének és a tokozásnak a teljesítménykezelő képességével kapcsolatosak.
Mint kapcsolóeszközöknél, a dinamikus paraméterek is lényegesek, mert ezek birtokában lehet értékelni a kapcsolási veszteségeket. A legtöbbet emlegetett dinamikus jóságmutató szám az RDS(on) és a kaputöltés szorzata, az RDS(on) × Qg érték, miközben egyre fontosabb a záróirányú töltésmennyiség, a Qrr értéke is. A kapuvezérlő méretezését és a kapcsolóeszköz megfelelő forrásáram vagy befolyó áram szolgáltatásához szükséges képességeit – és mindezt túllövés, lengések és egyéb torzítások nélkül – elsősorban ezek a jóságmutató számok határozzák meg.
Az első generációs SiC eszközök használatát és piaci részarányának növekedését megbízhatósági problémák hátráltatták. Ezek közé tartoztak a teljesítmény-MOSFET forrása és nyelője között elhelyezkedő pn-diódák. A pn-diódára kapcsolt feszültség gerjeszti azt, ami a nyitóirányú ellenállásnak az eszköz megbízhatóságát rontó változását eredményezi.
A Toshiba második generációja a MOSFET-be egy Schottky-határréteg-diódát (SBD – Schottky barrier diode –, röviden Schottky-dióda) ágyazva módosította az alapvető SiC eszköz felépítését, hogy nagyrészt megoldja ezt a problémát (4. ábra). Ez több mint egy nagyságrenddel javította a megbízhatóságot. Az új felépítés megakadályozta a pn-dióda gerjesztését azáltal, hogy a Schottky-diódát a pn-diódával párhuzamosan helyezték el a cellán belül. Az áram a beágyazott Schottky-diódán át folyik, mert annak nyitófeszültsége kisebb, mint a pn-diódáé, így elnyomja a nyitóirányú ellenállás bizonyos változásait, és csökkenti a MOSFET megbízhatóságának romlását.
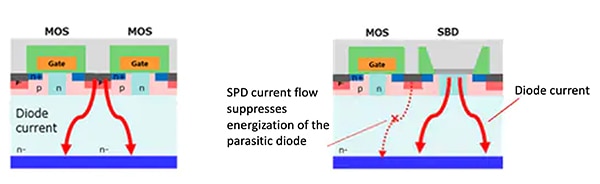 4. ábra: A belső Schottky-dióda (SBD) nélküli jellegzetes SiC MOSFET-tel (balra) ellentétben a Schottky-diódát tartalmazó SiC MOSFET (jobbra) képes minimálisra csökkenteni a parazita pn-dióda gerjesztését (kép: Toshiba)
4. ábra: A belső Schottky-dióda (SBD) nélküli jellegzetes SiC MOSFET-tel (balra) ellentétben a Schottky-diódát tartalmazó SiC MOSFET (jobbra) képes minimálisra csökkenteni a parazita pn-dióda gerjesztését (kép: Toshiba)
A beágyazott Schottky-diódát tartalmazó MOSFET-ek már a gyakorlatban is teret nyertek, de csak nagyfeszültségű – például 3,3 kV-os – eszközökben, mert a beágyazott Schottky-dióda miatt a nyitóirányú ellenállás végül olyan szintre emelkedett, amelyet csak a nagyfeszültségű eszközök képesek elviselni. A Toshiba módosítgatta a különböző eszközparamétereket, és azt állapította meg, hogy a Schottky-dióda MOSFET-en belüli területaránya a kulcs a megnövekedett nyitóirányú ellenállás csökkentéséhez. A Schottky-dióda méretarányának optimalizálásával a Toshiba kifejlesztett egy 1,2 kV-os SiC MOSFET-et, amelynek megbízhatósága jelentősen megnőtt.
Mint sok fejlesztés esetében, itt is voltak azonban kompromisszumok. Bár az új eszközfelépítés jelentősen javította a megbízhatóságot, két jóságmutató számra is káros hatással volt. Megnövelte ugyanis a névleges RDS(on), valamint az RDS(on) × Qg értéket, csökkentve a MOSFET teljesítményét. A bekapcsolási ellenállás kompenzálása és csökkentése érdekében a második generációs SiC MOSFET-eknél megnövelték a félvezetőszelet méretét, ez viszont növelte a költségeket.
A harmadik generáció igazi kiforrottságot mutat
A Toshiba ezt a problémát felismerve kifejlesztette a SiC MOSFET-ek harmadik generációját, a TWXXXN65C/TWXXXN120C termékcsaládot. Ezekben az eszközökben optimalizálták az áramvezető réteg szerkezetét, hogy csökkentsék a cellaméretet, valamint nagyobb névleges feszültséget, gyorsabb kapcsolást és kisebb nyitóirányú ellenállást tegyenek lehetővé.
A nyitóirányú ellenállás részben a vezetési ellenállás (Rspread) csökkentésével csökken. A Schottky-dióda áramát a SiC MOSFET széles p típusú diffúziós területének (p-zseb) aljába nitrogént beinjektálva növelték meg. A Toshiba a JFET-területet is csökkentette, és nitrogént injektált be a visszacsatolási kapacitás és a JFET-ellenállás csökkentése érdekében. Ennek eredményeképpen a visszacsatolási kapacitás anélkül csökkent, hogy a nyitóirányú ellenállás nőtt volna. A Schottky-dióda optimalizált elhelyezésével stabil, a nyitóirányú ellenállás ingadozása nélküli működést is sikerült elérni.
A termékcsalád jelenleg 650 V-os és 1200 V-os SiC MOSFET-ekből áll, amelyeket nagy teljesítményű ipari berendezésekben való használatra szántak, például 400 V-os és 800 V-os hálózati tápegységekbe, fényelektromos (PV, fotovoltaikus) inverterekbe és szünetmentes tápegységek (UPS, uninterruptible power supply) kétirányú egyenáram-átalakítóiba. Mind a 650 V-os, mind az 1200 V-os SiC MOSFET-ek az ágazati szabványú háromlábú TO-247-es tokozásban kaphatóak (5. ábra).
 5. ábra: A Toshiba szabványos TO-247-es tokozásban kapható 650 V-os és 1200 V-os harmadik generációs SiC MOSFET-jei jól használhatók sokféle áramátalakító, vezérlő- és felügyeleti berendezésben (kép: Toshiba)
5. ábra: A Toshiba szabványos TO-247-es tokozásban kapható 650 V-os és 1200 V-os harmadik generációs SiC MOSFET-jei jól használhatók sokféle áramátalakító, vezérlő- és felügyeleti berendezésben (kép: Toshiba)
Ezekben a harmadik generációs SiC MOSFET-ekben az RDS(on) × Qg jóságmutató szám 80%-kal kisebb a Toshiba második generációs eszközeihez képest – ami jelentős csökkenés –, miközben a kapcsolási veszteség körülbelül 20%-kal kevesebb. A beépített Schottky-diódás megoldás emellett rendkívül alacsony nyitófeszültséget (VF) tesz lehetővé.
A MOSFET-ekkel kapcsolatban vannak más tervezési finomságok is. Vegyük például a VGSS feszültséget. A VGSS (kapu–forrás rövidzárási feszültség) az a legnagyobb feszültség, amely a kapu és a forrás között ráadható az eszközre, amikor a nyelő és a forrás rövidre van zárva. A harmadik generációs SiC eszközök esetében a VGSS-tartomány 10 V és 25 V között van, az ajánlott érték 18 V. A tág VGSS-tartomány megkönnyíti a tervezést, és egyúttal javítja az eszköz megbízhatóságát.
Emellett a kis ellenállás és a magasabb kapu-küszöbfeszültség (VGS(th)) – az a feszültség, amelynél a MOSFET-csatorna vezetni kezd – segít megelőzni a működési hibákat, például a MOSFET feszültséglökések, hirtelen meghibásodások vagy túllövések miatti véletlen kinyitását. Ez a feszültség 3,0 V-tól 5,0 V-ig terjed, és segít kiszámítható kapcsolási teljesítményt nyújtani minimális elvándorlás mellett, miközben lehetővé teszi az egyszerű kapuvezérlő-kialakítást.
A 650 V-os és 1200 V-os harmadik generációs SiC MOSFET-ek közelebbi vizsgálata
Ha vetünk egy pillantást a termékcsalád termékskálájának két ellentétes végén lévő eszközre, a 650 V-os és 1200 V-os MOSFET-re, jó láthatjuk, mettől meddig terjednek az eszköz képességei. A fizikai tokozása, a lábkiosztása és a rajzszimbóluma mindegyik eszköznek ugyanaz (6. ábra), de a jellemzőik eltérőek.
 6. ábra: A Toshiba harmadik generációs SiC MOSFET termékcsaládja minden tagjának azonos a fizikai elrendezése és rajzszimbóluma. Figyelje meg a beépített Schottky-dióda jelét a rajzszimbólumon belül (kép: Toshiba)
6. ábra: A Toshiba harmadik generációs SiC MOSFET termékcsaládja minden tagjának azonos a fizikai elrendezése és rajzszimbóluma. Figyelje meg a beépített Schottky-dióda jelét a rajzszimbólumon belül (kép: Toshiba)
Az egyik 650 V-os eszköz a TW015N65C jelű, 100 A névleges áramerősségű és 342 W teljesítményű n-csatornás eszköz. Jellemző műszaki adatai: 4850 pF bemeneti kapacitás (CISS), kis, 128 nC bemeneti kaputöltés (Qg) és mindössze 15 mΩ névleges RDS(on) nyitóirányú ellenállás.
A statikus és dinamikus paraméterek legkisebb, jellemző és legnagyobb értékeit tartalmazó táblázatok mellett az adatlapon grafikonok is találhatók, amelyek a kritikus paraméterek teljesítményét mutatják olyan tényezők függvényében, mint a hőmérséklet, a nyelőáram és a kapu–forrás feszültség (VGS). A 7. ábrán például az RDS(on) nyelő–forrás nyitóirányú ellenállás értéke látható a hőmérséklet, a nyelőáram (ID) és a VGS kapu–forrás feszültség függvényében.
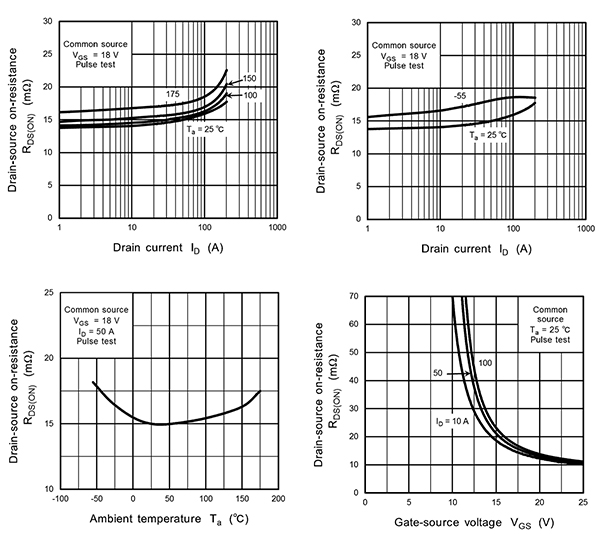 7. ábra: A TWO15N65C nyitóirányú ellenállását különböző tényezők, nevezetesen a nyelőáram, a környezeti hőmérséklet és a VGS kapu–forrás feszültség függvényében mutató grafikonok (kép: Toshiba)
7. ábra: A TWO15N65C nyitóirányú ellenállását különböző tényezők, nevezetesen a nyelőáram, a környezeti hőmérséklet és a VGS kapu–forrás feszültség függvényében mutató grafikonok (kép: Toshiba)
A 8. ábrán ugyanezek a jellemzők és grafikonok láthatók az 1200 V-os eszközökre, amilyen például a TW140N120C jelű, 20 A névleges áramerősségű, 107 W teljesítményű n-csatornás eszköz. Ennek a SiC MOSFET-nek kicsi, 6000 pF a CISS bemeneti kapacitása, 158 nC a bemeneti kaputöltése (Qg), és 140 mΩ az RDS(on) nyelő–forrás nyitóirányú ellenállása.
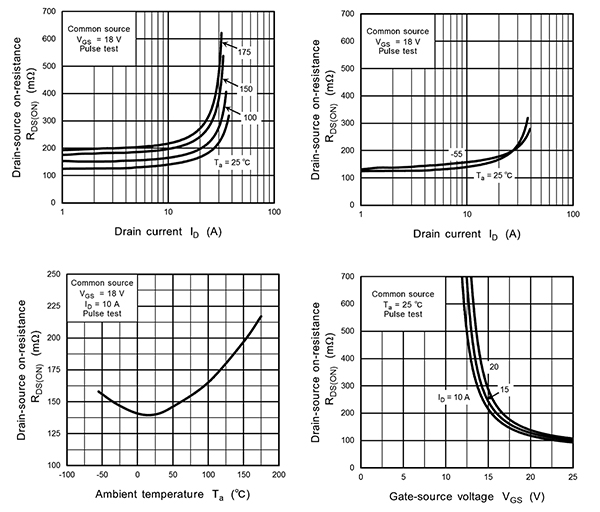 8. ábra: A TW140N120C nyitóirányú ellenállását mutató grafikonok (kép: Toshiba)
8. ábra: A TW140N120C nyitóirányú ellenállását mutató grafikonok (kép: Toshiba)
A Toshiba SiC MOSFET-ek harmadik generációjának tíz elérhető darabja öt 650 V-os és öt 1200 V-os eszközből áll. Ezeknek 25 °C-on a következő a nyitóirányú ellenállása, névleges áramerőssége és teljesítménye:
650 V:
- 15 mΩ, 100 A, 342 W (TWO15N65 típus)
- 27 mΩ, 58 A, 156 W
- 48 mΩ, 40 A, 132 W
- 83 mΩ, 30 A, 111 W
- 107 mΩ, 20 A, 70 W
1200 V:
- 15 mΩ, 100 A, 431 W
- 30 mΩ, 60 A, 249 W
- 45 mΩ, 40 A, 182 W
- 60 mΩ, 36 A, 170 W
- 140 mΩ, 20 A, 107 W (TW140N120C típus)
Összegzés
A szilícium-karbid MOSFET-ek a kritikus kapcsolási paraméterek tekintetében jelentősen jobb értékeket kínálnak a tisztán csak szilíciumból készült eszközöknél. A korábbi generációkhoz képest a harmadik generációs SiC eszközök jobb műszaki adatokat és jóságmutató számokat, nagyobb megbízhatóságot, a kapuvezérlés követelményeinek jobban megfelelő jelleggörbéket és a kialakítással járó szükségszerű finomságok jobb megismerhetőségét kínálják. Ezekkel a SiC MOSFET-ekkel a nagy teljesítményű rendszerek tervezői egy újabb nélkülözhetetlen erőforrást kapnak a kezükbe, amellyel jobb hatásfokot, kisebb méretet és nagyobb általános teljesítményt érhetnek el.

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.





